据韩媒报道,三星已确认从V10(第10代)开始,将合作使用新的先进封装技术“混合键合”。
行业分析人士表示,当三星NAND堆叠层数超过400层的时候,底部控制电路承受巨大压力,会影响NAND的可靠性。因此三星决定在V10产品上,使用存储单元与控制电路分别在不同硅片制造,然后再通过混合键合将其合并的技术路线。
存储核心技术之一
传统的二维芯片集成技术已逐渐接近物理极限。为了满足高算力、低功耗、高密度的需求,混合键合技术(Hybrid Bonding)应运而生,成为推动三维集成和异质集成的关键技术之一。
据国海证券和与非网,混合键合是一种先进的半导体封装技术,是指在一个键合步骤同时键合电介质和金属键合焊盘,属于无凸点永久键合的高密度互连技术。
它利用不同键合技术,在晶片和封装基板之间或者晶片内部实现互连,从而满足高性能集成电路对复杂互连结构的需求。
从2016年起,混合键合技术快速发展,成为半导体封装领域的关键技术。2016年,索尼率先在CMOS图像传感器中采用无凸点低温Cu-Cu混合键合技术,提升了图像传感器的性能。随后,SK海力士利用该技术开发了高带宽存储器(HBM)的晶圆对晶圆(W2W)堆叠,显著提高了存储器的带宽和性能。
2022年,英特尔展示了其Foveros Direct混合键合技术,能够实现10微米的互连节距和高密度互连,适用于高性能计算。2024年,AMD在其Instinct MI300系列芯片中采用混合键合技术,实现了3D VCache的堆叠,显著提升了缓存容量和计算性能。
国海证券表示,后摩尔时代,混合键合前景广阔。混合键合首先商用应用于CIS,后在3D NAND领域进入商业量产阶段,未来HBM有望成为混合键合未来重要市场。集邦咨询指出,随着对HBM产品日益增长的带宽需求,三大领先厂商SK海力士、三星和美光正在积极探索在HBM4 16hi产品中引入混合键合,并已确定在HBM5 20hi产品中大规模应用。

设备是核心环节
从市场规模来看,混合键合技术市场正以显著增速扩张,Business Research预计将从2024年的2亿美元攀升至2033年的7亿美元。
而设备市场作为核心环节,Business Research预计2030年需求总量预计达1400台,累计市场规模预计突破28亿欧元。这一增长主要由AI算力需求驱动,其在高密度集成、低功耗传输上的优势使其成为3D封装的关键技术,尤其在高性能计算和存储领域,如英特尔计划在2024年通过Foveros平台实现逻辑芯片与互连器的混合键合,海力士则拟在HBM4中率先应用该技术以突破16层堆叠瓶颈。
此外,疆亘资本指出,混合键合产业链竞争格局呈现全球化与本土化并进趋势。国际巨头如AMAT、ASMPT通过并购加速技术整合,而中国厂商拓荆科技、华卓精科已在关键设备领域取得突破,配合国家第三代半导体创新中心的建设,正逐步构建本土化供应链。
随着2030年全球数据中心能效需求提升至现有水平的10倍,混合键合作为实现“算力-功耗-体积”三角平衡的核心技术,将成为半导体产业持续进化的战略支点。
*免责声明:文章内容仅供参考,不构成投资建议
*风险提示:股市有风险,入市需谨慎
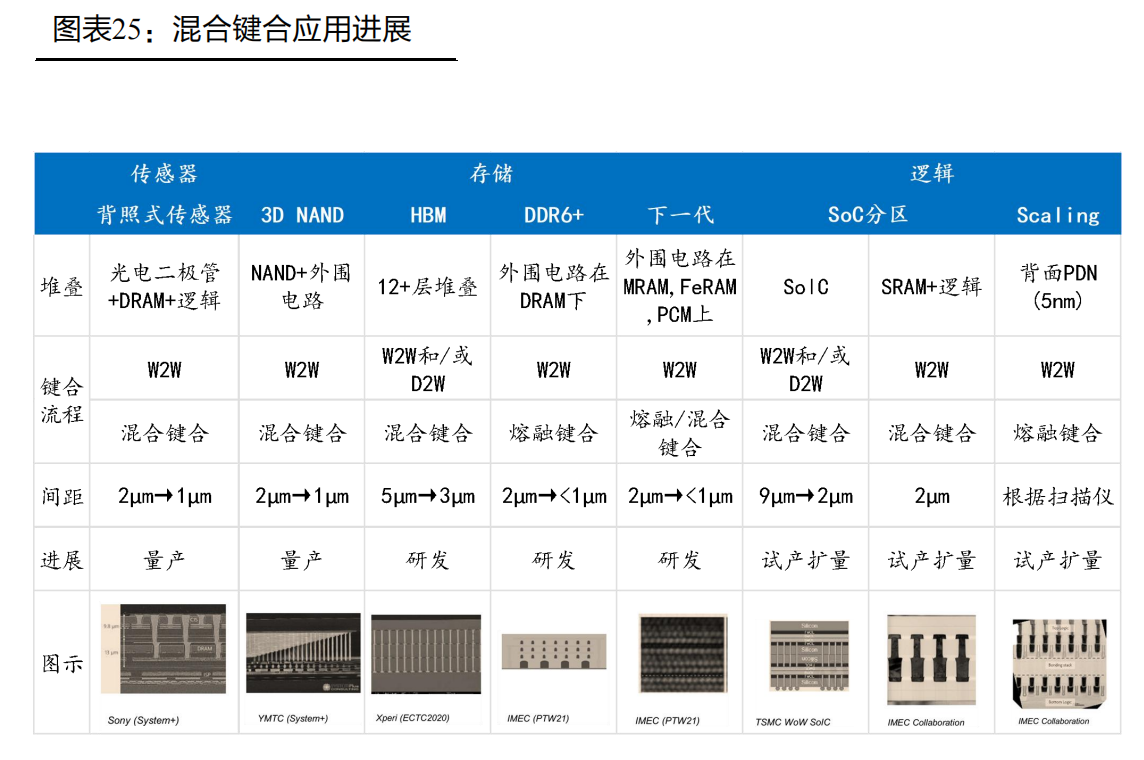



 沪公网安备31011802004900号
沪公网安备31011802004900号

